浏览数量: 3 作者: 本站编辑 发布时间: 2019-12-27 来源: 本站
本文分别从IGBT芯片结构、背面集电区结构和正面MOS结构等方面,系统分析了大功率IGBT芯片的技术现状和特点,从芯片焊接和电极互连两个方面进行了综合分析。介绍了IGBT模块的封装技术,并从新结构、新技术和新材料技术三个方面分析了IGBT技术未来的发展方向。

绝缘栅双极型晶体管(Insulated Gate Bipolar Transistor,简称IGBT)是在金属氧化物场效应晶体管(MOSFET)和双极型晶体管(Bipolar)基础上发展起来的一种新型复合功率器件,具有MOS输入和双极型功能输出。
IGBT具有压降低、电流密度大、耐压高、功率MOSFET驱动功率小、开关速度快、输入阻抗高、热稳定性好等优点。
作为电力电子变换器的核心器件,为应用装置的高频化、小型化、高性能、高可靠性奠定了基础。
自IGBT商业应用以来,作为新型功率半导体器件的主要类型,IGBT在1-100khz的频率应用范围中占有重要地位,电压范围为600V——6500V,电流范围为1A——3600A (140mm x 190mm 模块)。
IGBT广泛应用于工业、4C(通信、计算机、消费电子、汽车电子)、航空航天、国防等传统产业,以及轨道交通、新能源、智能电网、新能源汽车等战略性新兴产业。
采用IGBT进行电力变换,可以提高用电效率和质量,具有高效、节能、绿色环保的特点。是解决能源短缺问题、减少碳排放的关键支撑技术。因此被称为电源转换器产品的“CPU”、“绿色经济的核心”。
未来相当长一段时间内,IGBT将在满足全球CO2减排战略需求中发挥更加重要的作用,将成为节能技术和低碳经济的重要支点。
目前,全球大功率半导体公司对IGBT的研发热潮不断,研究和技术创新日益加快,IGBT芯片设计和生产厂商有英飞凌、ABB、三菱电机、Dynex(中国南车、
CSR)、IXYS公司、国际整流器公司、Powerex、飞利浦、摩托罗拉、富士电机、日立、东芝等,主要集中在欧洲、美洲、日本等国家。
由于多种原因,国内IGBT技术研发虽然起步较早,但进展缓慢,特别是在IGBT产业化方面还处于起步阶段,作为全球最大的IGBT应用市场,IGBT模块主要依赖进口。
近年来,在国家宏观政策的引导和组织下,国内企业通过多种渠道在IGBT芯片、模块等领域取得了很多可喜的进展,英国Dynex半导体CSR通过并购,充分利用欧洲丰富的资源技术资源,设立海外功率半导体研发中心,快速掌握先进的1200V至6500V IGBT芯片设计、制造工艺和模块封装技术,并在株洲建设先进的8英寸IGBT芯片封装生产线。
IGBT芯片将于2014年初量产。
IGBT真空共晶炉,由 火炬 ,为IGBT工厂提供动力,以专业的技术和工艺为中国制造的IGBT产品添砖加瓦。
在模块封装技术方面,我国已基本掌握了传统的焊接封装技术,其中中低压IGBT模块封装厂家较多,而高压IGBT模块封装主要以CSR和CNR为主。
与国外企业的技术差距仍然存在。
国外公司在传统封装技术的基础上,开发了多种先进封装技术,可以大幅度提高模块的功率密度、散热性能和长期可靠性,并初步实现了商业化应用。
火炬 同志的IGBT真空封装技术已经在比亚迪等大型IGBT公司经过长期验证。
2 技术状况
2.1 IGBT芯片技术
IGBT(真空共晶炉)芯片在结构上由数万个单元(重复单元)组成,采用大规模集成电路技术和功率器件技术制造[2]。
每个cell的结构如下图2所示,可分为三部分:本体结构、正面MOS结构和背面集电区结构。
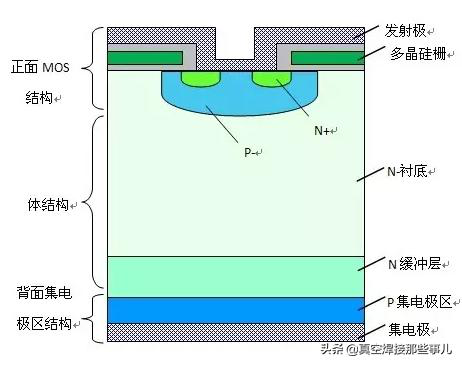
商用IGBT体积结构设计技术的发展经历了从穿通(PT)到非穿通(NPT)再到软穿通(SPT)的过程,如图3所示[3]。
在穿通结构出现之前,IGBT的体结构是基于厚晶圆扩散工艺的非穿通结构,背孔注入效率非常高。由于器件内部存在寄生晶闸管结构,IGBT工作时容易发生锁存现象,难以实现商用。
随着外延技术的发展,引入n型缓冲层,形成穿透结构,降低了背面空穴的注入效率,实现了批量应用。但由于外延技术的特点,高压IGBT的发展受到限制,其最高电压等级为1700V。
随着带状薄晶圆技术的发展,基于n型衬底的非直通结构IGBT推动了电压等级的不断提高,并且IGBT具有正温度系数通孔注入效率控制技术,可以更好地实现并联应用并提高应用功率水平。
随着电压等级的增加,芯片基板厚度也迅速增加,最终导致状态压降增大,为了优化状态压降和压力之间的关系,局部贯通结构应运而生,ABB称之为Soft英飞凌称为电场穿透(Soft Punch Through,SPT)[4],英飞凌称为电场穿透(Field Stop,FS)[5],三菱称为弱穿透(Light Punch Through,LPT)[6]。
IXYS 将其称为极轻穿通 (XPT),以及其他名称,例如薄穿通 (TPT) 和受控穿通 (CPT)[7]。
在相同耐压情况下,软穿通结构的厚度比非穿通结构厚度降低30%,同时保持非穿通结构的正温度系数。
近年来,各种增强型技术和超薄芯片技术都是基于软穿通的本体结构。目前600V电压等级软直通IGBT芯片厚度可达70um。

IGBT的集电极结构影响PNP晶体管的增益,对正向压降和关断损耗有重要影响。
早期的穿透型IGBT集电极区结深较大,空穴注入效率较大,容易产生闩锁效应。因此,必须采用局部寿命控制技术来控制背孔注入效率,但地表产生传导压降负温度系数,不利于并行应用。
后来的非穿透型IGBT,具有透明集电极结构,
控制空穴注入,消除局部寿命控制,实现传导压降正温度系数。这种结构技术一直沿用至今,并经过优化,提高了关断速度和短路安全工作区特性。
针对1200V以下芯片因芯片厚度原因加工困难的问题,提出了一种“内透明集电极”结构,采用氦离子注入和外延的方法,避免了超薄芯片的加工加工技术形成透明集热器。
集电极结构对安全工作区尤其是短路安全工作区的特性也有重要影响。对于对短路安全工作区特性有特殊要求的应用,可以通过控制和优化集电极区的掺杂浓度来实现关断损耗与集电极区的掺杂浓度和缓冲层的注入效率之间的折衷。集电极面积和缓冲层的注入效率。
IGBT的正面MOS结构包括栅极区和发射极区。
栅格结构有平面浇口(图4(a))和沟槽浇口(图4(b))两种类型。
平面栅结构栅氧化层质量好,栅电容小,不会造成栅底部电场集中而影响耐压。因此广泛应用于高压IGBT(电压等级3300V及以上)。
通过平面栅极结构的优化和改进,可以进一步降低栅极电容并改善其他工作特性,例如减少栅极存储时间、降低开关损耗、降低短路安全工作区(SCSOA)测试中的栅极电压过压等。 16]。
将沟道和沟槽栅极结构从水平改为垂直,消除了RJFET导通电阻的影响,还可以提高单元密度,从而降低功耗[17],因此它们广泛应用于低压(1700V)和耐压等级产品,但沟槽刻蚀后表面粗糙,会造成电场集中,载流子迁移率降低而影响击穿电压,且多晶硅栅面积增大,使栅电容增大,另外,由于电流密度导致栅电容减小的短路容量。
为了减小栅极电容,降低短路电流,需要对蜂窝结构进行优化,如图5所示。
三菱提出了“单元组合”IGBT结构(plugged/dummy cells)[18-19](图6),以降低饱和电流,提高短路能力,抑制短路测试时栅极电压振荡。
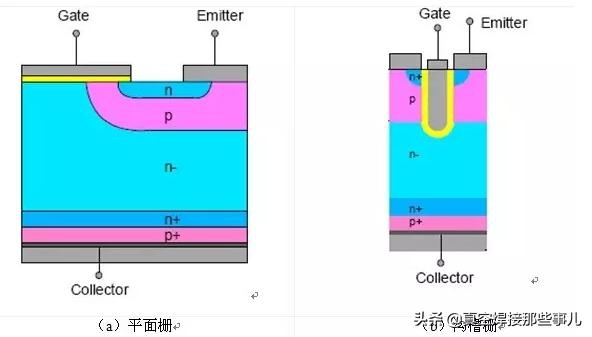
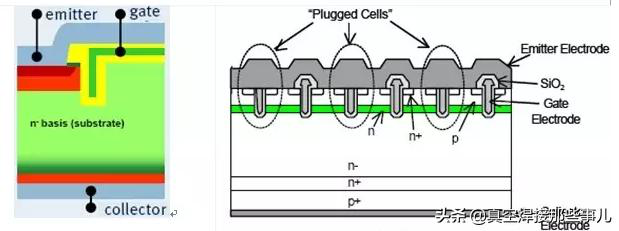
为了满足不同的封装需求,IGBT栅极可以位于芯片的中心、边缘和角落的中心,对于焊接封装,这三个位置都可以满足要求,对于压缩封装,一般选择将栅电极设置在拐角处。
目前先进的增强技术是通过优化正面MOS结构来提高靠近发射极区末端的电子注入效率,从而优化开关压降和关断损耗之间的权衡关系(图7).
常用的是载流子存储层(CSL)/空穴势垒层(HBL)结构,如图8所示。
从图中可以看出,该结构通过在p阱的外围设置n型掺杂区来包围p阱。
掺杂区缩短了沟道长度,增加了空穴载流子流向IGBT发射极的势垒,从而在P-陷阱中形成了空穴积累层,提高了在传导电子的情况下MOS沟道的注入效率,增强其电导率调制效果,可以显着降低器件的传导损耗。
在实现工艺上,可以采用自对准工艺,无需增加光刻次数。
然而,发现p陷阱下方的n掺杂区域对于芯片的耐压性能不利。
为了在开关压降和阻断电压之间取得更好的折衷,发展了p阱旁的n型掺杂技术,即在p阱两侧形成一对对称的n掺杂区。 - 嗯,如图 9 [23] 所示。
与载流子存储层/空穴势垒结构技术相比,不同之处在于掺杂区域没有围绕p-trap的底部和角落,从而有效降低片上压降,同时保持芯片的耐压能力达到最大程度。
其他增强措施包括优化沟槽的胞状结构或采用特殊的沟槽结构来降低基区空穴引出效率,从而达到电子注入增强的目的,在保持低匝数的同时降低传导损耗。断损失。
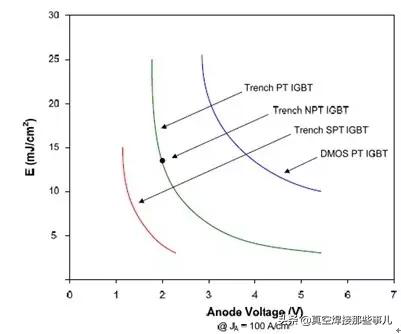
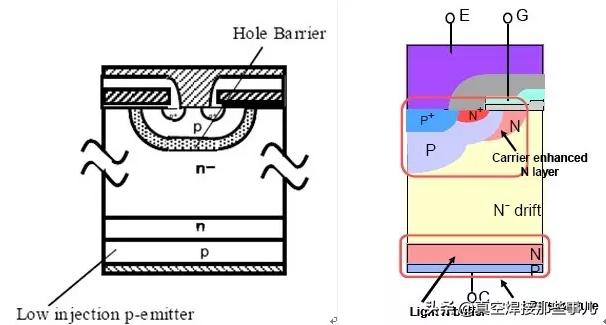
IGBT、IGBT真空焊接炉、IGBT真空共晶炉、IGBT真空回流焊、锡锡焊接、Au80Sn20焊接、Au88Ge12、预置锡锡盖、铟合金焊片、锡银铜SAC焊片、铅-无焊锡片、Ag72Cu28、In52Sn48、铟银合金焊锡片、Sn90Sb10、Sn63Pb37、锡铅焊锡片、金基焊锡片
、银基焊料、铟、金锗焊料、锦熙焊料封装、锦熙、IGBT高洁净焊料焊接、预涂助焊剂焊件、填充预制焊件、锡焊、SMT Ag92.5 Cu7.5焊接、Bi58Sn42焊件、Pb60In40焊件、In60Pb40焊件、Pb75In25焊件、In50Sn50焊件、低温焊锡、丸、Zn95Al4Cu1焊件、In51Bi32。5 SN16。5个焊片,In66.3 Bi33.7焊片,Ag62Sn35Pb3焊片
Ag60Cu23Sn17 预成型焊片、无助焊剂焊料、焊带
如果您对我们的产品感兴趣,请访问我们的网站(火炬网) 或搜索 IGBT真空焊接 在百度上烤箱了解我们的产品。